
IGBT的基本開關原理體現在單極型的MOS柵結構和雙極型PNP晶體管的相互作用。參照圖1所示的基本結構和等效電路。
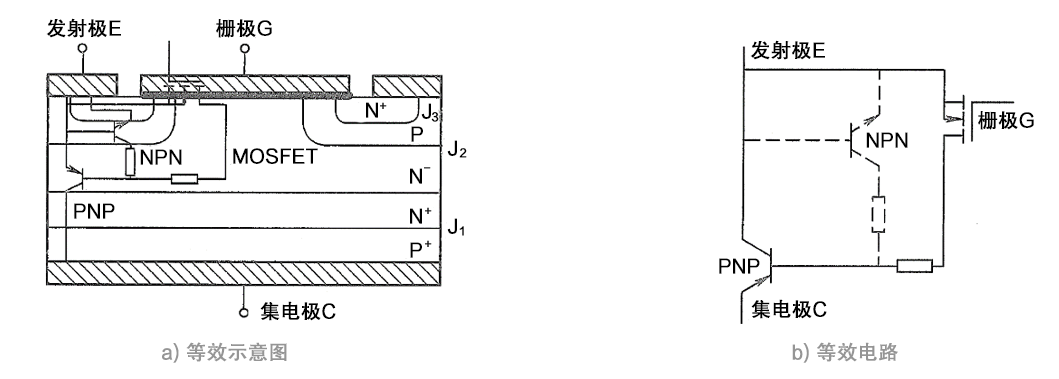
圖1 IGBT等效電路
IGBT的導通
當IGBT處于正向偏置并阻斷時,增加柵極-發射極電壓大于MOS結構的開啟電壓時,MOS結構中至柵極下面的P區表面強反型層形成導電溝道時,IGBT即進入正向導通狀態。此時電子可由發射極連接的N+區經溝道進入N區,相當于為PNP晶體管基極提供了電子流。同時,由于J1結處于正偏狀態,P+區將向N區注入空穴,一部分與電子復合,一部分經過J2結電場作用進入IGBT的發射極(準確地說是PNP晶體管的集電極)。此時整個IGBT中有電流流通,IGBT導通。在N區內,電子和空穴積累,形成電導調制效應。
IGBT的通態
IGBT通態時流經的電流能力同時受到柵極電壓和集電極-發射極正偏壓影響,而物理機制則是受到單極型和雙極型導電特性的影響。當IGBT的集電極-發射極正偏壓升高時,集電極的正偏置的PN結注入空穴的密度也相應升高,直到超過N區中平衡時的多子濃度為止。按照這種工作方式,只要柵壓足夠高,能使向N區提供電子的導電溝道開得足夠寬,則IGBT的通態電壓-電流特性就與PIN二極管的通態特性沒有多少差別。即便是額定阻斷電壓值很高的器件,其電流容量也能達到很高的水平,雙極型器件的特性表現得就多。但是在柵壓較低的情況下,由于反型層導電溝道的導電能力不夠,電阻較大,外加電壓將主要降落在這個區域中,則IGBT的電壓-電流將如一般MOSFET那樣顯現飽和特征。表現為單極型導電行為也就多一些。這兩種作用相互作用,就形成圖2所示的輸出特性。
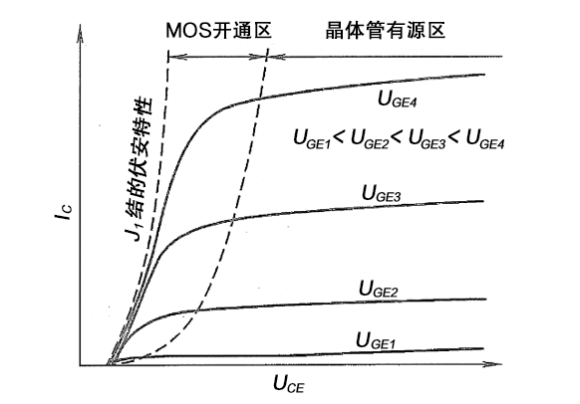
圖2 IGBT的輸出特性
圖2給出了單極型MOS結構特性占主導的飽和區,以及晶體管特性占主導的有源區。IGBT中的電流進入飽和的特性不是純粹的MOSFET中那樣的電子流飽和特性(否則就只是MOSFET了),當電流增加和集電極-發射極間電壓增加到一定程度時,晶體管部分承擔了IGBT電流中的主要部分,使MOSFET部分電流不再繼續進入飽和狀態,所以IGBT中的電流飽和也稱為次飽和。
IGBT的關斷
對于已經處于正向偏置并導通狀態的IGBT,如果想令其轉入關斷狀態,只需讓柵壓UGS<UT就行了,一種簡單的方式是通過柵極與發射極短路來實現的。當UGS降至零時,MOS柵結構中的P區表面不再能維持反型狀態,導電溝道消失,切斷了發射極對N基區的電子供給,關斷過程開始。由于IGBT導通時有P+區向N區注入少子空穴,這些少子在向J2結方同擴散的同時,在N區存儲起一定容量的載流子,像任何一種雙極型器件的正向導通過程那樣,因而其關斷過程也不能立即結束。這些少子需要一定的時間來通過復合和掃出而消失,也即集電極電流需要一定的時間逐漸衰減。
IGBT的寄生晶閘管的擎住效應
上述分析IGBT通態和關斷都是在寄生晶閘管不發生作用的情況下的結果。在實際應用中,IGBT的寄生晶閘管發生擎住作用,可分為兩種:
靜態擎住效應
動態擎住效應
IGBT的正向阻斷
當IGBT處于正向偏置時,即IGBT集電極接正電位,發射極接負電位。而柵極-發射極電壓小于MOS結構的開啟電壓時,集電極的PN結正偏置,對阻斷沒有貢獻,所以IGBT的正向阻斷原理與VDMOSFET相似。由于MOS柵結構中沒有溝道形成,無法為PNP晶體管的基極提供電流。整個IGBT可以看成是沒有基極電流的PNP晶體管,處于阻斷狀態。如果考慮寄生晶閘管的作用,也可以看成是沒有門極觸發的晶閘管,此時需要避免其他條件來觸發晶閘管。IGBT的正向阻斷電壓能力,主要是由J2結的雪崩擊穿電壓來決定的,IGBT正向偏置的情況如圖3所示。這時只有非常小的漏電流,當正向電壓超過閾值電壓就會發生擊穿。
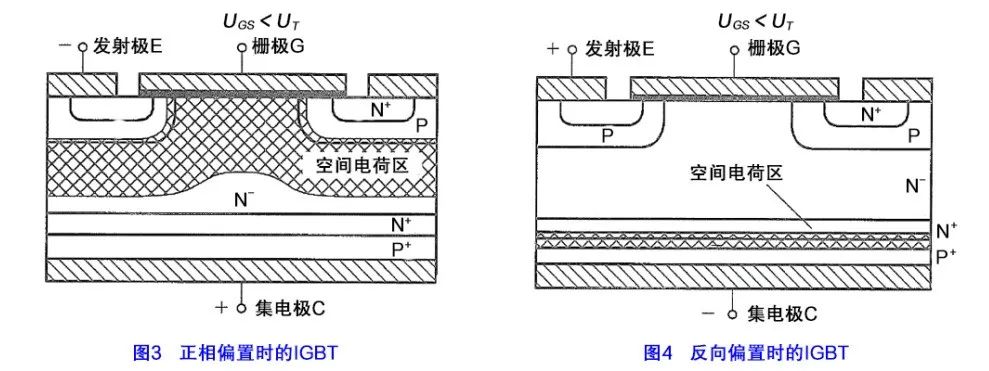
IGBT的反向阻斷
當IGBT反向偏置時,集電極的PN結反向偏置,J1結的存在使得IGBT有了承受反向電壓的能力,這是與MOSFET不同的特性,MOSEET在反向偏置時,將會表現出正向偏置的二極管特性,不具有反向阻斷的能力。但是,在IGBT中,設計者通常犧牲很大的反向阻斷能力來換取低電導率和低關斷損耗。因此,J1結的反向擊穿電壓較低,IGBT的反向阻斷能力不高。IGBT反向偏置時的情況如圖4所示。
在很多電壓型電力電子變換器中,都在IGBT中加入獨立的反并聯二極管,以適應變換器換流的需要,形成的逆導型器件的圖形符號如圖5a所示;而在一些電流型電力電子變換器或者矩陣變換器中,需要IGBT具有好的反向阻斷能力,則在IGBT中串聯獨立的二極管,形成圖5b所示的逆阻型器件圖形符號。
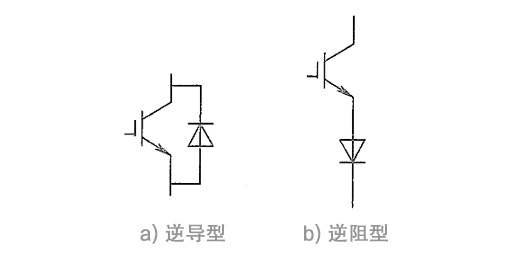
圖5 逆導型和逆阻型IGBT圖形符號
文章來源:三菱電機半導體



